BGA返修臺(tái)溫度曲線快速設(shè)置具體方法
BGA焊接芯片的溫度,BGA返修臺(tái)溫度曲線快速設(shè)置,BGA芯片元器件返修操作過程,快速設(shè)置最合適的溫度曲線是BGA返修臺(tái)焊接芯片成功的關(guān)鍵因素。與普通生產(chǎn)的回流焊接溫度曲線快速設(shè)置對(duì)比,BGA返修操作過程對(duì)溫度控制要求的要更加高。通常情況下BGA返修的溫度曲線圖能夠拆分成提前預(yù)熱、加熱、恒溫、熔焊、回焊、降溫6個(gè)部份。下面就讓科技小編給大家介紹下BGA返修臺(tái)溫度曲線設(shè)置的具體方法。
BGA返修臺(tái)溫度曲線快速設(shè)置的注意事項(xiàng)
1、現(xiàn)在SMT最常用的錫主要有兩種:有鉛和無鉛。無鉛成分為:鉛Pb錫SN銀AG銅CU。有鉛的焊膏熔點(diǎn)是183℃/,無鉛的有217℃/。就是說當(dāng)?shù)臏囟鹊竭_(dá)183度時(shí),有鉛的錫膏逐漸開始熔化。現(xiàn)在使用比較廣泛的有無鉛芯片提前預(yù)熱區(qū)的溫度升溫速度時(shí)間控制在1.2~5℃/s(秒),保溫區(qū)溫度控制 在160~190℃,回流焊區(qū)最高值的溫度設(shè)置為235~245℃間,加溫時(shí)長(zhǎng)10~45秒,從加熱到最高值的溫度的時(shí)間保持在一分半到兩分鐘左右就可以了。
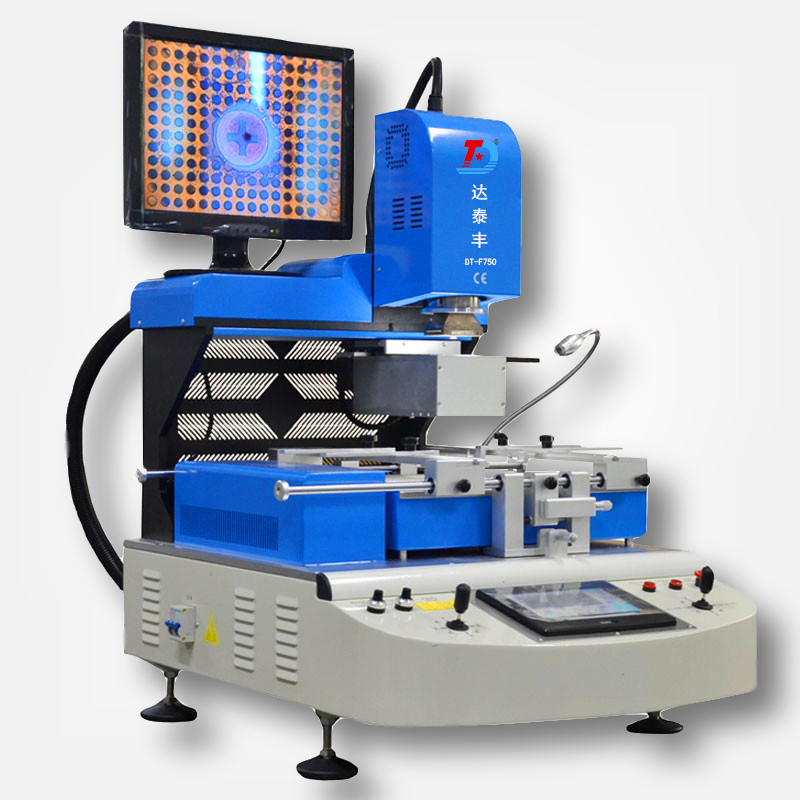
DT-F750全自動(dòng)光學(xué)對(duì)位BGA返修臺(tái)
BGA返修臺(tái)溫度曲線峰值設(shè)置
2、焊接時(shí),考慮到各個(gè)廠商對(duì)溫度控溫定義有所不同和BGA芯片自身因傳熱的主要原因,傳到BGA芯 片錫珠部位溫度要比熱風(fēng)出口相差一定的溫度。因此在調(diào)節(jié)濕度檢測(cè)時(shí),我們把測(cè)溫線插進(jìn)到BGA和PCB中間,同時(shí)確保測(cè)溫線最前端外露部分的都插進(jìn)去。然后根據(jù)需要調(diào)整風(fēng)量、風(fēng)速達(dá)到均勻可控的加熱目的。這樣測(cè)出來的BGA返修臺(tái)加熱精度溫度才是最精確的,這個(gè)方法大家在操作過程中務(wù)必注意。
BGA返修臺(tái)焊接芯片溫度設(shè)置
接下來給大家介紹一下使用BGA返修臺(tái)焊接芯片時(shí)溫度曲線的設(shè)置方法。
加熱:前期加熱和升溫段,它的作用就在于除去PCB板上面的水氣,預(yù)防起泡,對(duì)一整塊PCB達(dá)到加熱作用,預(yù)防熱損壞。通常溫度要求為:在加熱階段,溫度可設(shè)置在60℃-100℃之間,通常設(shè)置70-80℃,45s之間可起到加熱作用。假如較高,那就說明我們?cè)O(shè)置的升溫段溫度較高,還可以將升溫段溫度調(diào)低些或時(shí)間縮短些。 假如稍低,可以通過加熱段和升溫段溫度調(diào)高些或時(shí)間延長(zhǎng)些。
BGA返修臺(tái)溫度曲線設(shè)置流程雖說有點(diǎn)麻煩,但我們只需測(cè)式一次,把溫度曲線保存后就能夠反復(fù)使用,是一勞永逸的事,我們?cè)谠O(shè)置的過程當(dāng)中必須要細(xì)心耐心一步一步進(jìn)行操作好。這樣才可以保證BGA返修臺(tái)焊接芯片時(shí)溫度曲線設(shè)置正確,并保證返修良率。
